

–£—Ā–Ľ–ĺ–≤–Ĺ–ĺ —Ā—ā—Ä—É–ļ—ā—É—Ä–į—ā–į –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į –ľ–ĺ–∂–Ķ¬†–ī–į —Ā–Ķ –Ņ—Ä–Ķ–ī—Ā—ā–į–≤–ł –ļ–į—ā–ĺ R1-O-R2, –ļ—ä–ī–Ķ—ā–ĺ R1 –ł R2 —Ā–į —Ā—ä–ĺ—ā–≤–Ķ—ā–Ĺ–ĺ —Ā–≤–Ķ—ā–Ľ–ĺ—á—É–≤—Ā—ā–≤–ł—ā–Ķ–Ľ–Ĺ–į—ā–į –ł –Ņ–ĺ–Ľ–ł–ľ–Ķ—Ä–Ĺ–į —Ā—ä—Ā—ā–į–≤–Ĺ–į —á–į—Ā—ā, –į –ě –Ķ —Ā—ä–Ķ–ī–ł–Ĺ—Ź–≤–į—Č–ł—Ź—ā –≥–ł –ļ–ł—Ā–Ľ–ĺ—Ä–ĺ–ī–Ķ–Ĺ –į—ā–ĺ–ľ (—ā–į–ļ–ł–≤–į –ĺ—Ä–≥–į–Ĺ–ł—á–Ĺ–ł —Ā—ä–Ķ–ī–ł–Ĺ–Ķ–Ĺ–ł—Ź —Ā–Ķ –Ĺ–į—Ä–ł—á–į—ā –Ņ—Ä–ĺ—Ā—ā–ł –Ķ—ā–Ķ—Ä–ł).
–ě—Ā–Ĺ–ĺ–≤–Ĺ–ł—ā–Ķ —Ā—ä–ĺ–Ī—Ä–į–∂–Ķ–Ĺ–ł—Ź, –ļ–ĺ–ł—ā–ĺ —ā—Ä—Ź–Ī–≤–į –ī–į —Ā–Ķ –ł–ľ–į—ā –Ņ—Ä–Ķ–ī–≤–ł–ī –Ņ—Ä–ł –ł–∑–Ī–ĺ—Ä –ł –ł–∑–Ņ–ĺ–Ľ–∑–≤–į–Ĺ–Ķ –Ĺ–į –≤—Ā—Ź–ļ–į–ļ–≤–ł —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł –≤ —ā–Ķ—Ö–Ĺ–ĺ–Ľ–ĺ–≥–ł–ł—ā–Ķ –Ĺ–į –ü–ü –Ņ—Ä–ł–Ī–ĺ—Ä–ł—ā–Ķ –ł –ł–Ĺ—ā–Ķ–≥—Ä–į–Ľ–Ĺ–ł—ā–Ķ —Ā—Ö–Ķ–ľ–ł, —Ā–į —Ā–≤–Ķ—ā–Ľ–ĺ—á—É–≤—Ā—ā–≤–ł—ā–Ķ–Ľ–Ĺ–ĺ—Ā—ā—ā–į, —Ä–Ķ–∑–ĺ–Ľ—é—Ü–ł—Ź—ā–į, —Ä–į–∑–ī–Ķ–Ľ–ł—ā–Ķ–Ľ–Ĺ–į—ā–į —Ā–Ņ–ĺ—Ā–ĺ–Ī–Ĺ–ĺ—Ā—ā, —É—Ā—ā–ĺ–Ļ—á–ł–≤–ĺ—Ā—ā—ā–į –ļ—ä–ľ –≤—ä–∑–ī–Ķ–Ļ—Ā—ā–≤–ł–Ķ –Ĺ–į –≥–į–∑–ĺ–≤–į –Ņ–Ľ–į–∑–ľ–į, –ļ–ł—Ā–Ķ–Ľ–ł–Ĺ–ĺ—É—Ā—ā–ĺ–Ļ—á–ł–≤–ĺ—Ā—ā—ā–į, –į–ī—Ö–Ķ–∑–ł—Ź—ā–į, –ī–Ķ—Ą–Ķ–ļ—ā–Ĺ–ĺ—Ā—ā—ā–į –ł –≤–ł—Ā–ĺ–ļ–į—ā–į –ļ–ĺ–Ĺ—ā—Ä–į—Ā—ā–Ĺ–ĺ—Ā—ā.
–ß—É–≤—Ā—ā–≤–ł—ā–Ķ–Ľ–Ĺ–ĺ—Ā—ā
–° —ā–į–∑–ł –ī—É–ľ–į —Ā–Ķ –ĺ–∑–Ĺ–į—á–į–≤–į –∑–į—Ä—Ź–ī—ä—ā, –ļ–ĺ–Ļ—ā–ĺ –Ķ –Ĺ–Ķ–ĺ–Ī—Ö–ĺ–ī–ł–ľ–ĺ –ī–į —Ā–Ķ –Ņ—Ä–Ķ–ī–į–ī–Ķ –Ĺ–į¬† —É—á–į—Ā—ā—ä–ļ –Ĺ–į —Ä–Ķ–∑–ł—Ā—ā–į —Ā —Ü–Ķ–Ľ –Ņ—ä–Ľ–Ĺ–ĺ—ā–ĺ –ľ—É –Ņ—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ –∑–į –Ĺ—Ź–ļ–į–ļ–≤–ĺ –≤—Ä–Ķ–ľ–Ķ (–ĺ–Ī–ł–ļ–Ĺ–ĺ–≤–Ķ–Ĺ–ĺ 1-2 –ľ–ł–Ĺ—É—ā–ł). –§–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā—ä—ā —Ā—ä–ī—ä—Ä–∂–į —Ā–≤–Ķ—ā–Ľ–ĺ—á—É–≤—Ā—ā–≤–ł—ā–Ķ–Ľ–Ĺ–ĺ –≤–Ķ—Č–Ķ—Ā—ā–≤–ĺ, –Ņ–ĺ–≥–Ľ—ä—Č–į—Č–ĺ —É–Ľ—ā—Ä–į–≤–ł–ĺ–Ľ–Ķ—ā–ĺ–≤–į —Ā–≤–Ķ—ā–Ľ–ł–Ĺ–į –ĺ—ā –≤—ä–Ľ–Ĺ–ł —Ā –ī—ä–Ľ–∂–ł–Ĺ–į –≤ –ĺ–Ņ—Ä–Ķ–ī–Ķ–Ľ–Ķ–Ĺ –ł–Ĺ—ā–Ķ—Ä–≤–į–Ľ. –ß—É–≤—Ā—ā–≤–ł—ā–Ķ–Ľ–Ĺ–ĺ—Ā—ā—ā–į –ĺ–Ņ—Ä–Ķ–ī–Ķ–Ľ—Ź —Ä—Ź–∑–ļ–ĺ—Ā—ā—ā–į –Ĺ–į –≥—Ä–į–Ĺ–ł—Ü–į—ā–į –ľ–Ķ–∂–ī—É —Ä–į–∑—ā–≤–ĺ—Ä–ł–ľ–ł –ł –Ĺ–Ķ—Ä–į–∑—ā–≤–ĺ—Ä–ł–ľ–ł –ĺ–Ī–Ľ–į—Ā—ā–ł, –ļ–ĺ–Ķ—ā–ĺ –Ņ—Ä–ł —Ą–ĺ—ā–ĺ–Ľ–ł—ā–ĺ–≥—Ä–į—Ą—Ā–ļ–ł—Ź –Ņ—Ä–ĺ—Ü–Ķ—Ā —Ā–Ķ –ł–∑—Ä–į–∑—Ź–≤–į –≤ –Ņ–ĺ–Ľ—É—á–į–≤–į–Ĺ–Ķ –Ĺ–į —Ä—Ź–∑—ä–ļ —Ä—ä–Ī –Ĺ–į –≥–Ķ–ĺ–ľ–Ķ—ā—Ä–ł—á–Ĺ–į—ā–į –ļ–ĺ–Ĺ—Ą–ł–≥—É—Ä–į—Ü–ł—Ź, –ł–∑–ĺ–Ī—Ä–į–∑–Ķ–Ĺ–į –Ņ–ĺ-—Ä–į–Ĺ–ĺ –≤—ä—Ä—Ö—É —Ą–ĺ—ā–ĺ—ą–į–Ī–Ľ–ĺ–Ĺ–į. –Ē–į —Ā–Ķ –ĺ–Ņ—Ä–Ķ–ī–Ķ–Ľ–ł —ā–ĺ–∑–ł –ł–Ĺ—ā–Ķ—Ä–≤–į–Ľ –Ķ –≤—ä–∑–ľ–ĺ–∂–Ĺ–ĺ, –ł–∑—Ö–ĺ–∂–ī–į–Ļ–ļ–ł –ĺ—ā –į–Ī—Ā–ĺ—Ä–Ī—Ü–ł–ĺ–Ĺ–Ĺ–ł—Ź —Ā–Ņ–Ķ–ļ—ā—ä—Ä –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į. –Ē—ä–Ľ–∂–ł–Ĺ–į—ā–į –Ĺ–į –≤—ä–Ľ–Ĺ–ł—ā–Ķ –Ķ –≤ –į–Ī—Ā–ĺ—Ä–Ī—Ü–ł–ĺ–Ĺ–Ĺ–ł—Ź —Ā–Ņ–Ķ–ļ—ā—ä—Ä –Ĺ–į —Ä–Ķ–∑–ł—Ā—ā–į —ā–ĺ–≥–į–≤–į, –ļ–ĺ–≥–į—ā–ĺ –ĺ–Ņ—ā–ł—á–Ĺ–į—ā–į –Ņ–Ľ—ä—ā–Ĺ–ĺ—Ā—ā –Ĺ–į —Ä–Ķ–∑–ł—Ā—ā–Ĺ–ł—Ź —Ą–ł–Ľ–ľ –Ķ –Ĺ–Ķ –Ņ–ĺ-–ľ–į–Ľ–ļ–ĺ –ĺ—ā 0.2. –Ę–ĺ–∑–ł —É—á–į—Ā—ā—ä–ļ —Ā–Ķ –Ĺ–į—Ä–ł—á–į –ĺ–Ī–Ľ–į—Ā—ā –Ĺ–į —Ā–Ņ–Ķ–ļ—ā—Ä–į–Ľ–Ĺ–į—ā–į —á—É–≤—Ā—ā–≤–ł—ā–Ķ–Ľ–Ĺ–ĺ—Ā—ā –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į.
–ü–ĺ–Ĺ—Ź–ļ–ĺ–≥–į —Ā–Ķ –≥–ĺ–≤–ĺ—Ä–ł –ł –∑–į –ł–Ĺ—ā–Ķ–≥—Ä–į–Ľ–Ĺ–į —Ā–≤–Ķ—ā–Ľ–ĺ—á—É–≤—Ā—ā–≤–ł—ā–Ķ–Ľ–Ĺ–ĺ—Ā—ā –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į. –Ę–ĺ–≤–į –Ķ —Ā–≤–Ķ—ā–Ľ–ĺ—á—É–≤—Ā—ā–≤–ł—ā–Ķ–Ľ–Ĺ–ĺ—Ā—ā—ā–į –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į –ļ—ä–ľ –≤—ä–∑–ī–Ķ–Ļ—Ā—ā–≤–ł–Ķ—ā–ĺ –Ĺ–į —Ā–≤–Ķ—ā–Ľ–ł–Ĺ–į –ĺ—ā –≤—Ā–ł—á–ļ–ł –ī—ä–Ľ–∂–ł–Ĺ–ł –Ĺ–į –≤—ä–Ľ–Ĺ–ł—ā–Ķ, –Ņ–ĺ–≥–Ľ—ä—Č–į–Ĺ–ł –ĺ—ā –ľ–į—ā–Ķ—Ä–ł–į–Ľ–į.
–ó–Ĺ–į–Ķ–Ļ–ļ–ł —Ā–≤–Ķ—ā–Ľ–ĺ—á—É–≤—Ā—ā–≤–ł—ā–Ķ–Ľ–Ĺ–ĺ—Ā—ā—ā–į (~100 mJ/cm2) –ł –ĺ—Ā–≤–Ķ—ā–Ķ–Ĺ–ĺ—Ā—ā—ā–į, –ľ–ĺ–∂–Ķ –ī–į —Ā–Ķ –ĺ–Ņ—Ä–Ķ–ī–Ķ–Ľ–ł –Ņ—Ä–ł–ľ–Ķ—Ä–Ĺ–ĺ –≤—Ä–Ķ–ľ–Ķ –∑–į –Ķ–ļ—Ā–Ņ–ĺ–Ĺ–ł—Ä–į–Ĺ–Ķ –∑–į –ī–į–ī–Ķ–Ĺ –≤–ł–ī —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā. –ė–Ĺ—ā–Ķ–Ĺ–∑–ł–≤–Ĺ–ĺ—Ā—ā—ā–į –Ĺ–į –∂–ł–≤–į—á–Ĺ–ł—ā–Ķ –Ľ–į–ľ–Ņ–ł –Ķ ~300-500 –ľ–í—ā/—Ā–ľ2. –Ę–ĺ—á–Ĺ–ĺ—ā–ĺ –≤—Ä–Ķ–ľ–Ķ –Ĺ–į –Ķ–ļ—Ā–Ņ–ĺ–Ĺ–ł—Ä–į–Ĺ–Ķ —Ā–Ķ —É—Ā—ā–į–Ĺ–ĺ–≤—Ź–≤–į –ĺ–Ņ–ł—ā–Ĺ–ĺ –ł –Ķ –ľ–Ķ–∂–ī—É 10-20 —Ā–Ķ–ļ—É–Ĺ–ī–ł –ł –Ĺ—Ź–ļ–ĺ–Ľ–ļ–ĺ –ľ–ł–Ĺ—É—ā–ł. –§–ł—Ä–ľ–ł—ā–Ķ-–Ņ—Ä–ĺ–ł–∑–≤–ĺ–ī–ł—ā–Ķ–Ľ–ł –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā –ĺ–Ī–ł–ļ–Ĺ–ĺ–≤–Ķ–Ĺ–ĺ –ĺ–Ī—Ź–≤—Ź–≤–į—ā —á—É–≤—Ā—ā–≤–ł—ā–Ķ–Ľ–Ĺ–ĺ—Ā—ā –∑–į –Ņ—Ä–ĺ—Ź–≤–ł—ā–Ķ–Ľ–ł —Ā –ĺ–Ņ—Ä–Ķ–ī–Ķ–Ľ–Ķ–Ĺ —Ā—ä—Ā—ā–į–≤ –ł —É—Ā–Ľ–ĺ–≤–ł—Ź –Ĺ–į –Ņ—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ. –í—Ā–Ķ–ļ–ł –Ņ–ĺ—ā—Ä–Ķ–Ī–ł—ā–Ķ–Ľ –Ķ–ļ—Ā–Ņ–Ķ—Ä–ł–ľ–Ķ–Ĺ—ā–į–Ľ–Ĺ–ĺ –Ņ–ĺ–ī–Ī–ł—Ä–į "–ī–ĺ–∑–į—ā–į" –∑–į —Ā–≤–ĺ–ł—ā–Ķ –ļ–ĺ–Ĺ–ļ—Ä–Ķ—ā–Ĺ–ł –Ĺ—É–∂–ī–ł.
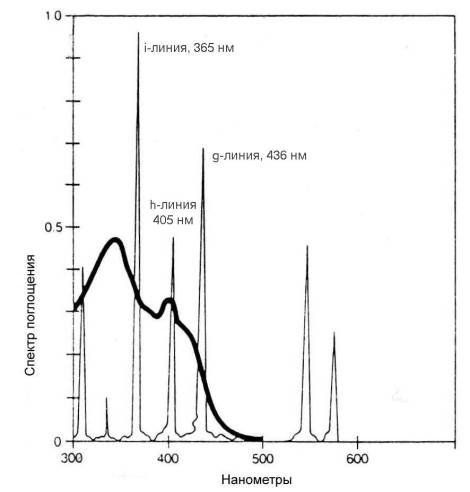
–†–į–∑–ī–Ķ–Ľ–ł—ā–Ķ–Ľ–Ĺ–į —Ā–Ņ–ĺ—Ā–ĺ–Ī–Ĺ–ĺ—Ā—ā
–ě–Ņ—Ä–Ķ–ī–Ķ–Ľ—Ź —Ā–Ķ –ĺ—ā –Ī—Ä–ĺ—Ź –Ĺ–į –Ľ–ł–Ĺ–ł–ł—ā–Ķ —Ā –Ķ–ī–Ĺ–į–ļ–≤–į –ł –Ņ–ĺ—Ā—ā–ĺ—Ź–Ĺ–Ĺ–į —ą–ł—Ä–ł–Ĺ–į, –ļ–ĺ–ł—ā–ĺ –ľ–ĺ–≥–į—ā –ī–į —Ā–Ķ –Ņ–ĺ–Ľ—É—á–į—ā –Ĺ–į –Ķ–ī–ł–Ĺ–ł—Ü–į –ī—ä–Ľ–∂–ł–Ĺ–į –ĺ—ā –Ņ–ĺ–≤—ä—Ä—Ö–Ĺ–ĺ—Ā—ā—ā–į (–Ĺ–į–Ļ-—á–Ķ—Ā—ā–ĺ 1 –ľ–ľ) –Ĺ–į –Ņ–ĺ–Ľ—É–Ņ—Ä–ĺ–≤–ĺ–ī–Ĺ–ł–ļ–ĺ–≤–į—ā–į –Ņ–Ľ–į—Ā—ā–ł–Ĺ–į. –ö–ĺ–Ľ–ļ–ĺ—ā–ĺ –Ņ–ĺ–≤–Ķ—á–Ķ –Ľ–ł–Ĺ–ł–ł –ľ–ĺ–≥–į—ā –ī–į —Ā–Ķ –Ņ–ĺ–Ľ—É—á–į—ā –Ĺ–į –Ķ–ī–ł–Ĺ–ł—Ü–į –ī—ä–Ľ–∂–ł–Ĺ–į, —ā–ĺ–Ľ–ļ–ĺ–≤–į –Ņ–ĺ-–≥–ĺ–Ľ—Ź–ľ–į –Ķ —Ä–į–∑–ī–Ķ–Ľ–ł—ā–Ķ–Ľ–Ĺ–į—ā–į —Ā–Ņ–ĺ—Ā–ĺ–Ī–Ĺ–ĺ—Ā—ā. –ú–į–ļ—Ā–ł–ľ–į–Ľ–Ĺ–į—ā–į –†–ü –∑–į–≤–ł—Ā–ł –ł –ĺ—ā —Ä–į–∑–ľ–Ķ—Ä–ł—ā–Ķ –Ĺ–į –Ņ–ĺ–Ľ–ł–ľ–Ķ—Ä–Ĺ–ł—ā–Ķ –ľ–ĺ–Ľ–Ķ–ļ—É–Ľ–ł –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į, –į —Ā—ä—Č–ĺ –ł –ĺ—ā –ľ–ł–Ĺ–ł–ľ–į–Ľ–Ĺ–į—ā–į –ī–Ķ–Ī–Ķ–Ľ–ł–Ĺ–į, –Ņ—Ä–ł –ļ–ĺ—Ź—ā–ĺ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–Ĺ–ł—Ź—ā —Ą–ł–Ľ–ľ –Ķ —Ā–Ņ–ĺ—Ā–ĺ–Ī–Ķ–Ĺ –ī–į –Ņ–ĺ–Ĺ–Ķ—Ā–Ķ –≤—ä–∑–ī–Ķ–Ļ—Ā—ā–≤–ł–Ķ –≤ –į–≥—Ä–Ķ—Ā–ł–≤–Ĺ–į —Ā—Ä–Ķ–ī–į. –ě—ā–Ĺ–ĺ—ą–Ķ–Ĺ–ł–Ķ—ā–ĺ –Ĺ–į –ī–Ķ–Ī–Ķ–Ľ–ł–Ĺ–į—ā–į –Ĺ–į —Ą–ł–Ľ–ľ–į –ļ—ä–ľ –ľ–ł–Ĺ–ł–ľ–į–Ľ–Ĺ–į—ā–į —ą–ł—Ä–ł–Ĺ–į –Ĺ–į –Ľ–ł–Ĺ–ł–ł—ā–Ķ –∑–į –Ĺ–į–Ļ-–ī–ĺ–Ī—Ä–ł—ā–Ķ –Ĺ–Ķ–≥–į—ā–ł–≤–Ĺ–ł —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł –Ķ 1:2-1:3, –į –∑–į –Ņ–ĺ–∑–ł—ā–ł–≤–Ĺ–ł—ā–Ķ ‚Äď 1:1. –Ę–ĺ–Ķ—Ā—ā –∑–į –Ņ–ĺ–Ľ—É—á–į–≤–į–Ĺ–Ķ—ā–ĺ –Ĺ–į –Ľ–ł–Ĺ–ł–ł —Ā –ľ–ł–Ĺ–ł–ľ–į–Ľ–Ĺ–į —ą–ł—Ä–ł–Ĺ–į —Ā–Ķ –ĺ—ā—á–ł—ā–į –ł –ī–Ķ–Ī–Ķ–Ľ–ł–Ĺ–į—ā–į –Ĺ–į —Ä–Ķ–∑–ł—Ā—ā–Ĺ–ł—Ź —Ā–Ľ–ĺ–Ļ. –Ě–į–Ļ-–ī–ĺ–Ī—Ä–į—ā–į —Ä–į–∑–ī–Ķ–Ľ–ł—ā–Ķ–Ľ–Ĺ–į —Ā–Ņ–ĺ—Ā–ĺ–Ī–Ĺ–ĺ—Ā—ā –Ĺ–į –Ņ–ĺ–∑–ł—ā–ł–≤–Ĺ–ł—ā–Ķ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł –Ņ–ĺ–∑–≤–ĺ–Ľ—Ź–≤–į —ā–Ķ –ī–į —Ā–Ķ –ł–∑–Ņ–ĺ–Ľ–∑–≤–į—ā –∑–į –Ņ—Ä–ĺ–ł–∑–≤–ĺ–ī—Ā—ā–≤–ĺ –Ĺ–į —Ā–≤—Ä—ä—Ö–≥–ĺ–Ľ–Ķ–ľ–ł –ł–Ĺ—ā–Ķ–≥—Ä–į–Ľ–Ĺ–ł —Ā—Ö–Ķ–ľ–ł.
–Ě–į –†–ü –≤–Ľ–ł—Ź–Ĺ–ł–Ķ –ĺ–ļ–į–∑–≤–į—ā —Ā—ä—Č–ĺ —ā–į–ļ–į –Ņ—Ä–ĺ—Ü–Ķ—Ā–ł—ā–Ķ –Ĺ–į –Ķ–ļ—Ā–Ņ–ĺ–Ĺ–ł—Ä–į–Ĺ–Ķ –ł —Ā–≤—ä—Ä–∑–į–Ĺ–ł—ā–Ķ —Ā —ā—Ź—Ö –ĺ–Ņ—ā–ł—á–Ĺ–ł —Ź–≤–Ľ–Ķ–Ĺ–ł—Ź –≤ —Ā–ł—Ā—ā–Ķ–ľ–į—ā–į "—Ą–ĺ—ā–ĺ—ą–į–Ī–Ľ–ĺ–Ĺ-—Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā-–Ņ–ĺ–ī–Ľ–ĺ–∂–ļ–į", –į —Ā—ä—Č–ĺ —ā–į–ļ–į –Ņ—Ä–ĺ—Ü–Ķ—Ā–ł—ā–Ķ –Ĺ–į –Ņ—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ –ł —Ā—É—ą–Ķ–Ĺ–Ķ. –ö—ä–ľ –ĺ–Ņ—ā–ł—á–Ĺ–ł—ā–Ķ —Ź–≤–Ľ–Ķ–Ĺ–ł—Ź, –ĺ–ļ–į–∑–≤–į—Č–ł –≤–Ľ–ł—Ź–Ĺ–ł–Ķ –Ĺ–į –†–ü, —ā—Ä—Ź–Ī–≤–į –ī–į —Ā–Ķ –ĺ—ā–Ĺ–Ķ—Ā–Ķ –ł –ī–ł—Ą—Ä–į–ļ—Ü–ł—Ź—ā–į –Ĺ–į —Ā–≤–Ķ—ā–Ľ–ł–Ĺ–į—ā–į –Ĺ–į –≥—Ä–į–Ĺ–ł—Ü–į—ā–į —Ą–ĺ—ā–ĺ—ą–į–Ī–Ľ–ĺ–Ĺ-—Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā, –ĺ—ā—Ä–į–∂–Ķ–Ĺ–ł–Ķ—ā–ĺ –Ĺ–į —Ā–≤–Ķ—ā–Ľ–ł–Ĺ–į—ā–į –ĺ—ā –Ņ–ĺ–≤—ä—Ä—Ö–Ĺ–ĺ—Ā—ā—ā–į –Ĺ–į —Ā–ł–Ľ–ł—Ü–ł–Ķ–≤–į—ā–į –Ņ–ĺ–ī–Ľ–ĺ–∂–ļ–į –ł —Ä–į–∑—Ā–Ķ–Ļ–≤–į–Ĺ–į—ā–į —Ā–≤–Ķ—ā–Ľ–ł–Ĺ–į –≤—ä–≤ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–Ĺ–ł—Ź —Ā–Ľ–ĺ–Ļ.
–°—ā–į–Ī–ł–Ľ–Ĺ–ĺ—Ā—ā—ā–į –Ĺ–į –≥–Ķ–ĺ–ľ–Ķ—ā—Ä–ł—á–Ĺ–ł—ā–Ķ —Ä–į–∑–ľ–Ķ—Ä–ł –Ĺ–į —Ä–Ķ–Ľ–Ķ—Ą–Ĺ–ł—ā–Ķ –Ķ–Ľ–Ķ–ľ–Ķ–Ĺ—ā–ł –Ĺ–į –ł–∑–ĺ–Ī—Ä–į–∂–Ķ–Ĺ–ł–Ķ—ā–ĺ –≤—ä–≤ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–Ĺ–ł—Ź —Ā–Ľ–ĺ–Ļ –∑–į–≤–ł—Ā–ł –≤ –≥–ĺ–Ľ—Ź–ľ–į —Ā—ā–Ķ–Ņ–Ķ–Ĺ –ĺ—ā —ā–ĺ–≤–į –ļ–į–ļ —ā–ĺ—á–Ĺ–ĺ —Č–Ķ —Ā–Ķ –ł–∑–Ņ—ä–Ľ–Ĺ—Ź—ā –Ņ—Ä–ĺ—Ü–Ķ—Ā–ł—ā–Ķ –Ĺ–į –Ņ—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ –ł –ł–∑—Ā—É—ą–į–≤–į–Ĺ–Ķ. –ü—Ä–Ķ-–Ņ—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ—ā–ĺ –≤–ĺ–ī–ł –ī–ĺ —É–≤–Ķ–Ľ–ł—á–Ķ–Ĺ–ł–Ķ –Ĺ–į —Ä–į–∑–ľ–Ķ—Ä–ł—ā–Ķ –Ĺ–į –Ķ–Ľ–Ķ–ľ–Ķ–Ĺ—ā–ł—ā–Ķ (–ĺ—Ā–ĺ–Ī–Ķ–Ĺ–ĺ –∑–į –Ņ–ĺ–∑–ł—ā–ł–≤–Ĺ–ł—ā–Ķ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł), –į –Ĺ–Ķ–ī–ĺ–Ī—Ä–ł—ā–Ķ —Ä–Ķ–∂–ł–ľ–ł –Ĺ–į –ł–∑—Ā—É—ą–į–≤–į–Ĺ–Ķ –ľ–ĺ–≥–į—ā –ī–į –ī–ĺ–≤–Ķ–ī–į—ā –ī–ĺ —Ä–į–∑–Ņ—É–ļ–≤–į–Ĺ–Ķ –ł —Ä–į–∑–Ņ–į–ī–į–Ĺ–Ķ –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–Ĺ–ł—Ź —Ą–ł–Ľ–ľ.
–Ę—Ä—Ź–Ī–≤–į –ī–į —Ā–Ķ –ĺ—ā–Ī–Ķ–Ľ–Ķ–∂–ł, —á–Ķ –Ķ –Ĺ–Ķ–ĺ–Ī—Ö–ĺ–ī–ł–ľ–ĺ –ī–į —Ā–Ķ –Ņ—Ä–į–≤–ł —Ä–į–∑–Ľ–ł–ļ–į –ľ–Ķ–∂–ī—É —Ä–į–∑–ī–Ķ–Ľ–ł—ā–Ķ–Ľ–Ĺ–į —Ā–Ņ–ĺ—Ā–ĺ–Ī–Ĺ–ĺ—Ā—ā –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į –ł —ā–į–ļ–į–≤–į –Ĺ–į —Ą–ĺ—ā–ĺ–Ľ–ł—ā–ĺ–≥—Ä–į—Ą—Ā–ļ–ł—Ź –Ņ—Ä–ĺ—Ü–Ķ—Ā —Ā –ł–∑–Ņ–ĺ–Ľ–∑–≤–į–Ĺ–Ķ –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā, –Ĺ–į–Ĺ–Ķ—Ā–Ķ–Ĺ –≤—ä—Ä—Ö—É —Ā–ł–Ľ–ł—Ü–ł–Ķ–≤–į—ā–į –Ņ–Ľ–į—Ā—ā–ł–Ĺ–į.
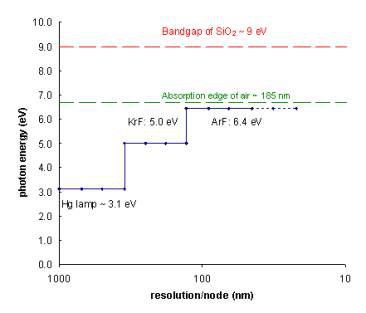
–ö–ł—Ā–Ķ–Ľ–ł–Ĺ–ĺ—É—Ā—ā–ĺ–Ļ—á–ł–≤–ĺ—Ā—ā—ā–į –Ķ –ĺ—Ā–Ĺ–ĺ–≤–Ķ–Ĺ –ļ—Ä–ł—ā–Ķ—Ä–ł–Ļ –∑–į –Ņ—Ä–ł–Ľ–ĺ–∂–ł–ľ–ĺ—Ā—ā—ā–į –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł—ā–Ķ, —ā—ä–Ļ –ļ–į—ā–ĺ —ā–Ķ —ā—Ä—Ź–Ī–≤–į –ī–į –∑–į—Č–ł—ā–į–≤–į—ā –Ĺ–į–ī–Ķ–∂–ī–Ĺ–ĺ –Ľ–Ķ–∂–į—Č–ł—ā–Ķ –Ņ–ĺ–ī —ā—Ź—Ö —Ā–Ľ–ĺ–Ķ–≤–Ķ –Ņ—Ä–ł –Ņ–ĺ—Ā–Ľ–Ķ–ī–≤–į—Č–ł—ā–Ķ —ā–Ķ—Ö–Ĺ–ĺ–Ľ–ĺ–≥–ł—á–Ĺ–ł –ĺ–Ņ–Ķ—Ä–į—Ü–ł–ł –Ņ–ĺ —Ö–ł–ľ–ł—á–Ķ—Ā–ļ–ĺ—ā–ĺ —Ä–į–∑—ā–≤–į—Ä—Ź–Ĺ–Ķ (–Ķ—Ü–≤–į–Ĺ–Ķ). –ě–Ī–ł–ļ–Ĺ–ĺ–≤–Ķ–Ĺ–ĺ –ł–∑–Ņ–ĺ–Ľ–∑–≤–į–Ĺ–ł—ā–Ķ —Ä–į–∑—ā–≤–ĺ—Ä–ł —Ā–į –Ĺ–į –ĺ—Ā–Ĺ–ĺ–≤–į—ā–į –Ĺ–į –į–∑–ĺ—ā–Ĺ–į, —Ą–Ľ—É–ĺ—Ä–ĺ–≤–ĺ–ī–ĺ—Ä–ĺ–ī–Ĺ–į, —Ā–ĺ–Ľ–Ĺ–į –ł –ī—Ä. –ļ–ł—Ā–Ķ–Ľ–ł–Ĺ–ł. ¬†–ó–į –ļ—Ä–ł—ā–Ķ—Ä–ł–Ļ –Ĺ–į –ļ–ł—Ā–Ķ–Ľ–ł–Ĺ–ĺ—É—Ā—ā–ĺ–Ļ—á–ł–≤–ĺ—Ā—ā—ā–į —Ā–Ķ –ł–∑–Ņ–ĺ–Ľ–∑–≤–į —Ā—ā—Ä–į–Ĺ–ł—á–Ĺ–ĺ—ā–ĺ (–ļ—Ä–į–Ķ–≤–ĺ—ā–ĺ) –ł –Ľ–ĺ–ļ–į–Ľ–Ĺ–ĺ—ā–ĺ —Ä–į–∑—Ź–∂–ī–į–Ĺ–Ķ (–Ņ–ĺ–ī–Ķ—Ü–≤–į–Ĺ–Ķ) –ł –Ņ–ĺ-—ā–ĺ—á–Ĺ–ĺ –≥–ĺ–Ľ–Ķ–ľ–ł–Ĺ–į—ā–į –Ĺ–į —Ā–ļ–Ľ–ĺ–Ĺ–į, –ĺ–Ī—Ä–į–∑—É–≤–į—Č —Ā–Ķ –Ĺ–į –ļ—Ä–į—Ź –Ĺ–į —Ä–Ķ–∑–ł—Ā—ā–Ĺ–ł—Ź —Ą–ł–Ľ–ľ —Ā–Ľ–Ķ–ī –Ķ—Ü–≤–į–Ĺ–Ķ.
–ö—Ä–ł—ā–Ķ—Ä–ł–Ļ –∑–į –ļ–ł—Ā–Ķ–Ľ–ł–Ĺ–ĺ—É—Ā—ā–ĺ–Ļ—á–ł–≤–ĺ—Ā—ā—ā–į –Ķ —Ā—ä—Č–ĺ —ā–į–ļ–į –≤—Ä–Ķ–ľ–Ķ—ā–ĺ, –≤ —ā–Ķ—á–Ķ–Ĺ–ł–Ķ –Ĺ–į –ļ–ĺ–Ķ—ā–ĺ —Ä–į–∑—ā–≤–ĺ—Ä—ä—ā –≤—ä–∑–ī–Ķ–Ļ—Ā—ā–≤–į –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–Ĺ–ł—Ź —Ā–Ľ–ĺ–Ļ –ī–ĺ –Ĺ–į—á–į–Ľ–ĺ—ā–ĺ –Ĺ–į —Ä–į–∑—Ä—É—ą–į–≤–į–Ĺ–Ķ, –į —Ā—ä—Č–ĺ —ā–į–ļ–į –ļ–į—á–Ķ—Ā—ā–≤–ĺ—ā–ĺ –Ĺ–į –Ņ–ĺ–Ľ—É—á–Ķ–Ĺ–ł—ā–Ķ —Ā—ā—Ä—É–ļ—ā—É—Ä–ł –≤ –Ņ–ĺ–ī–Ľ–ĺ–∂–ļ–į—ā–į —Ā–Ľ–Ķ–ī –Ķ—Ü–≤–į–Ĺ–Ķ—ā–ĺ. –ü–į—Ä–į–ľ–Ķ—ā—ä—Ä—ä—ā —á–Ķ—Ā—ā–ĺ —Ā–Ķ —Ö–į—Ä–į–ļ—ā–Ķ—Ä–ł–∑–ł—Ä–į —Ā –Ņ–Ľ—ä—ā–Ĺ–ĺ—Ā—ā –Ĺ–į –ī–Ķ—Ą–Ķ–ļ—ā–ł—ā–Ķ (–ļ–ĺ–Ľ–ł—á–Ķ—Ā—ā–≤–ĺ—ā–ĺ –ī–Ķ—Ą–Ķ–ļ—ā–ł –Ĺ–į –Ķ–ī–ł–Ĺ–ł—Ü–į –Ņ–ĺ–≤—ä—Ä—Ö–Ĺ–ĺ—Ā—ā), –Ņ–ĺ—Ź–≤–ł–Ľ–ł —Ā–Ķ –Ĺ–į –Ņ–ĺ–ī–Ľ–ĺ–∂–ļ–į—ā–į —Ā–Ľ–Ķ–ī –ļ—Ä–į—Ź –Ĺ–į —Ö–ł–ľ–ł—á–Ĺ–ł—Ź –Ņ—Ä–ĺ—Ü–Ķ—Ā.
–£—Ā—ā–ĺ–Ļ—á–ł–≤–ĺ—Ā—ā—ā–į –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į –Ĺ–į —Ö–ł–ľ–ł—á–Ĺ–ł –≤—ä–∑–ī–Ķ–Ļ—Ā—ā–≤–ł—Ź –∑–į–≤–ł—Ā–ł –Ĺ–Ķ —Ā–į–ľ–ĺ –ĺ—ā —Ā—ä—Ā—ā–į–≤–į, –Ĺ–ĺ –ł –ĺ—ā –ī–Ķ–Ī–Ķ–Ľ–ł–Ĺ–į—ā–į –ł —Ā—ä—Ā—ā–ĺ—Ź–Ĺ–ł–Ķ—ā–ĺ –Ĺ–į —Ä–Ķ–∑–ł—Ā—ā–Ĺ–į—ā–į –ľ–į—Ā–ļ–į. –ė–∑–Ņ–ĺ–Ľ–∑–≤–į —Ā–Ķ —Ą–ĺ—Ä–ľ—É–Ľ–į—ā–į K = h / —Ö, –ļ—ä–ī–Ķ—ā–ĺ h –Ķ –ī—ä–Ľ–Ī–ĺ—á–ł–Ĺ–į—ā–į –Ĺ–į –Ķ—Ü–≤–į–Ĺ–Ķ, –į x ‚Äď —Ā—ā—Ä–į–Ĺ–ł—á–Ĺ–ĺ—ā–ĺ (–ļ—Ä–į–Ķ–≤–ĺ—ā–ĺ) –Ņ–ĺ–ī–Ķ—Ü–≤–į–Ĺ–Ķ. –ö–ĺ–Ľ–ļ–ĺ—ā–ĺ –Ņ–ĺ-–ľ–į–Ľ–ļ–ĺ –Ķ —ā–ĺ –Ņ—Ä–ł –∑–į–ī–į–ī–Ķ–Ĺ–į –ī—ä–Ľ–Ī–ĺ—á–ł–Ĺ–į –Ĺ–į –Ķ—Ü–≤–į–Ĺ–Ķ, —ā–ĺ–Ľ–ļ–ĺ–≤–į –Ņ–ĺ-–≤–ł—Ā–ĺ–ļ–į –Ķ –ļ–ł—Ā–Ķ–Ľ–ł–Ĺ–ĺ—É—Ā—ā–ĺ–Ļ—á–ł–≤–ĺ—Ā—ā—ā–į –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į.
–ü–ĺ—Ä–į–ī–ł –ł–∑–Ņ–ĺ–Ľ–∑–≤–į–Ĺ–Ķ –Ĺ–į —Ā—É—Ö–ĺ—ā–ĺ –Ķ—Ü–≤–į–Ĺ–Ķ –Ĺ–į —Ā–ł–Ľ–ł—Ü–ł–Ķ–≤–į—ā–į –Ņ–ĺ–ī–Ľ–ĺ–∂–ļ–į –≤–į–∂–Ĺ–į —Ö–į—Ä–į–ļ—ā–Ķ—Ä–ł—Ā—ā–ł–ļ–į –Ķ —É—Ā—ā–ĺ–Ļ—á–ł–≤–ĺ—Ā—ā—ā–į –ļ—ä–ľ –≤—ä–∑–ī–Ķ–Ļ—Ā—ā–≤–ł–Ķ –Ĺ–į –≥–į–∑–ĺ–≤–į –Ņ–Ľ–į–∑–ľ–į. –Ę—ä–Ļ –ļ–į—ā–ĺ —Ā—ä—Č–Ķ—Ā—ā–≤—É–≤–į—ā –Ĺ—Ź–ļ–ĺ–Ľ–ļ–ĺ –į–Ľ—ā–Ķ—Ä–Ĺ–į—ā–ł–≤–Ĺ–ł —Ā—ä—Ā—ā–į–≤–ł –Ĺ–į –Ņ–Ľ–į–∑–ľ–ĺ–ĺ–Ī—Ä–į–∑—É–≤–į—Č–ł –≥–į–∑–ĺ–≤–Ķ –∑–į —Ā—É—Ö–ĺ –Ķ—Ü–≤–į–Ĺ–Ķ –Ĺ–į –Ķ–ī–ł–Ĺ –ł–Ľ–ł –ī—Ä—É–≥ –ľ–į—ā–Ķ—Ä–ł–į–Ľ –ĺ—ā –ľ–ł–ļ—Ä–ĺ–Ķ–Ľ–Ķ–ļ—ā—Ä–ĺ–Ĺ–ł–ļ–į—ā–į, –Ķ –Ĺ–Ķ–ĺ–Ī—Ö–ĺ–ī–ł–ľ–ĺ –ī–į —Ā–Ķ —É—ā–ĺ—á–Ĺ–ł —É—Ā—ā–ĺ–Ļ—á–ł–≤–ĺ—Ā—ā—ā–į –ļ—ä–ľ –ļ–ĺ–Ļ —ā–ĺ—á–Ĺ–ĺ –≤–ł–ī –Ņ–Ľ–į–∑–ľ–į —Ā–Ķ –ł–ľ–į –Ņ—Ä–Ķ–ī–≤–ł–ī. –ź–ļ–ĺ —Ā—ā–į–≤–į –ī—É–ľ–į –∑–į –ĺ–Ī—Ä–į–Ī–ĺ—ā–ļ–į —Ā —Ą–Ľ—É–ĺ—Ä–ĺ—Ā—ä–ī—ä—Ä–∂–į—Č–ł –Ņ–Ľ–į–∑–ľ–ł, –∑–į —Ö–į—Ä–į–ļ—ā–Ķ—Ä–ł—Ā—ā–ł–ļ–į –Ĺ–į —É—Ā—ā–ĺ–Ļ—á–ł–≤–ĺ—Ā—ā—ā–į –ĺ–Ī–ł–ļ–Ĺ–ĺ–≤–Ķ–Ĺ–ĺ —Ā–Ķ –ł–∑–Ņ–ĺ–Ľ–∑–≤–į –ĺ—ā–Ĺ–ĺ—Ā–ł—ā–Ķ–Ľ–Ĺ–į—ā–į —Ā–ļ–ĺ—Ä–ĺ—Ā—ā –Ĺ–į —Ä–į–∑—Ź–∂–ī–į–Ĺ–Ķ –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į –Ņ–ĺ –ĺ—ā–Ĺ–ĺ—ą–Ķ–Ĺ–ł–Ķ —Ā–ļ–ĺ—Ä–ĺ—Ā—ā—ā–į ¬†–Ĺ–į —Ä–į–∑—Ź–∂–ī–į–Ĺ–Ķ –Ĺ–į —Ā–ł–Ľ–ł—Ü–ł–Ķ–≤–ł—Ź –ī–≤—É–ĺ–ļ–ł—Ā SiO2. –ź–ļ–ĺ —Ā–Ķ –≥–ĺ–≤–ĺ—Ä–ł –∑–į –ĺ–Ī—Ä–į–Ī–ĺ—ā–ļ–į –Ĺ–į –Ņ–ĺ–Ľ–ł–ľ–Ķ—Ä–Ĺ–ł —Ā–Ľ–ĺ–Ķ–≤–Ķ, —ā–ĺ –ļ–į—ā–ĺ –ľ—Ź—Ä–ļ–į –∑–į —É—Ā—ā–ĺ–Ļ—á–ł–≤–ĺ—Ā—ā —Ā–Ķ –ł–∑–Ņ–ĺ–Ľ–∑–≤–į –ĺ—ā–Ĺ–ĺ—ą–Ķ–Ĺ–ł–Ķ—ā–ĺ –Ĺ–į —Ā–ļ–ĺ—Ä–ĺ—Ā—ā—ā–į –Ĺ–į —Ä–į–∑—Ź–∂–ī–į–Ĺ–Ķ –Ĺ–į –ľ–į—ā–Ķ—Ä–ł–į–Ľ–į –ļ—ä–ľ —Ā–ļ–ĺ—Ä–ĺ—Ā—ā—ā–į –Ĺ–į —Ä–į–∑—Ź–∂–ī–į–Ĺ–Ķ –Ĺ–į –Ņ–ĺ–Ľ–ł—Ā—ā–ł—Ä–ĺ–Ľ–į –≤ –Ņ–Ľ–į–∑–ľ–ł, —Ā—ä–ī—ä—Ä–∂–į—Č–ł –ļ–ł—Ā–Ľ–ĺ—Ä–ĺ–ī.
–°–Ľ–Ķ–ī–≤–į—Č–ĺ—ā–ĺ –ľ–Ĺ–ĺ–≥–ĺ –≤–į–∂–Ĺ–ĺ —Ā–≤–ĺ–Ļ—Ā—ā–≤–ĺ –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į –Ķ –Ĺ–Ķ–≥–ĺ–≤–į—ā–į –į–ī—Ö–Ķ–∑–ł—Ź. –Ę–ĺ–≤–į –ĺ–∑–Ĺ–į—á–į–≤–į –ī–ĺ–Ī—Ä–į—ā–į —Ā–Ņ–ĺ—Ā–ĺ–Ī–Ĺ–ĺ—Ā—ā –Ĺ–į –ľ–į—ā–Ķ—Ä–ł–į–Ľ–į –ī–į –Ņ—Ä–ł–Ľ—Ź–≥–į –Ĺ–į–ī —Ā–ł–Ľ–ł—Ü–ł–Ķ–≤–į—ā–į –Ņ–ĺ–ī–Ľ–ĺ–∂–ļ–į, –∑–į –ī–į —Ā–Ķ –ł–∑–Ī–Ķ–≥–Ĺ–Ķ –≤–Ľ–ł—Ź–Ĺ–ł–Ķ—ā–ĺ –Ĺ–į –ļ–ł—Ā–Ķ–Ľ–ł–Ĺ–Ĺ–ł—ā–Ķ —ā—Ä–į–≤–ł—ā–Ķ–Ľ–ł –≤—ä—Ä—Ö—É –ĺ–Ī–Ľ–į—Ā—ā–ł—ā–Ķ, –ļ–ĺ–ł—ā–ĺ —Ā–Ķ –Ĺ–į–ľ–ł—Ä–į—ā –Ņ–ĺ–ī –ļ—Ä–į–ł—Č–į—ā–į –Ĺ–į —Ä–Ķ–∑–ł—Ā—ā–ł–≤–Ĺ–ł—ā–Ķ —Ā–Ľ–ĺ–Ķ–≤–Ķ. –ź–ī—Ö–Ķ–∑–ł—Ź—ā–į —Ā–Ķ –Ņ–ĺ–ī–ĺ–Ī—Ä—Ź–≤–į —á—Ä–Ķ–∑ –ł–∑–Ņ–ĺ–Ľ–∑–≤–į–Ĺ–Ķ –Ĺ–į —Ä–į–∑–Ľ–ł—á–Ĺ–ł –≤–Ķ—Č–Ķ—Ā—ā–≤–į, –Ņ—Ä–į–≤–Ķ—Č–ł –Ņ–ĺ–≤—ä—Ä—Ö–Ĺ–ĺ—Ā—ā—ā–į —Ö–ł–ī—Ä–ĺ—Ą–ł–Ľ–Ĺ–į. –ė–∑–ł—Ā–ļ–≤–į–Ĺ–Ķ—ā–ĺ –∑–į —Ä–į–≤–Ĺ–ĺ–ľ–Ķ—Ä–Ĺ–ĺ—Ā—ā –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į –Ņ–ĺ –ī–Ķ–Ī–Ķ–Ľ–ł–Ĺ–į –Ķ –Ņ—Ä—Ź–ļ–ĺ —Ā–≤—ä—Ä–∑–į–Ĺ–ĺ —Ā —Ä–į–∑–ī–Ķ–Ľ–ł—ā–Ķ–Ľ–Ĺ–į—ā–į —Ā–Ņ–ĺ—Ā–ĺ–Ī–Ĺ–ĺ—Ā—ā, –į –ĺ—ā—ā–į–ľ –ł —Ā —ā–ĺ—á–Ĺ–ĺ—Ā—ā—ā–į –Ĺ–į –≥–Ķ–ĺ–ľ–Ķ—ā—Ä–ł—á–Ĺ–ł—ā–Ķ —Ä–į–∑–ľ–Ķ—Ä–ł –Ņ–ĺ –Ņ–Ľ–į—Ā—ā–ł–Ĺ–ł—ā–Ķ.
–Ē–Ķ—Ą–Ķ–ļ—ā–Ĺ–ĺ—Ā—ā—ā–į –Ķ –ļ–ĺ–Ľ–ł—á–Ķ—Ā—ā–≤–ĺ—ā–ĺ –Ĺ–į –ľ–ł–ļ—Ä–ĺ—Ā–ļ–ĺ–Ņ–ł—á–Ĺ–ł—ā–Ķ –ī–Ķ—Ą–Ķ–ļ—ā–ł –Ĺ–į —Ą–ł–Ľ–ľ–į, –Ņ—Ä–ĺ—Ź–≤—Ź–≤–į—Č–ł —Ā–Ķ –Ĺ–į —Ā–Ľ–Ķ–ī–≤–į—Č–ł—ā–Ķ —Ā—ā–į–ī–ł–ł –Ĺ–į –ĺ–Ī—Ä–į–Ī–ĺ—ā–ļ–į –Ĺ–į –Ņ–ĺ–ī–Ľ–ĺ–∂–ļ–į—ā–į. –ü–ĺ—Ź–≤–į—ā–į –Ĺ–į –ĺ—ā–≤–ĺ—Ä–ł –≤ –Ņ–ĺ–ļ—Ä–ł—ā–ł–Ķ—ā–ĺ –ĺ–Ī–ł–ļ–Ĺ–ĺ–≤–Ķ–Ĺ–ĺ –Ķ —Ā–≤—ä—Ä–∑–į–Ĺ–ĺ —Ā –Ĺ–Ķ–ļ–į—á–Ķ—Ā—ā–≤–Ķ–Ĺ –ł–Ľ–ł –ł–∑–Ĺ–ĺ—Ā–Ķ–Ĺ —ą–į–Ī–Ľ–ĺ–Ĺ, —Ä–į–∑–Ľ–ł—á–Ĺ–ł –∑–į–ľ—ä—Ä—Ā—Ź–≤–į–Ĺ–ł—Ź –ł –Ľ–ĺ—ą–į –Ĺ–į–ľ–ĺ–ļ—Ä—Ź–Ķ–ľ–ĺ—Ā—ā –Ĺ–į –Ņ–Ľ–į—Ā—ā–ł–Ĺ–į—ā–į.
–ú–Ķ—ā–ĺ–ī–ł—ā–Ķ –∑–į –Ĺ–į–ľ–į–Ľ—Ź–≤–į–Ĺ–Ķ –Ĺ–į –ī–Ķ—Ą–Ķ–ļ—ā–ł—ā–Ķ –≤ —Ä–Ķ–∑–ł—Ā—ā–į:
- –Ņ–ĺ-–ī–Ķ–Ī–Ķ–Ľ –ł–Ľ–ł –Ĺ–į–Ņ—Ä–į–≤–ĺ –ī–≤—É—Ā–Ľ–ĺ–Ķ–Ĺ —Ä–Ķ–∑–ł—Ā—ā
- –Ņ–ĺ—á–ł—Ā—ā–≤–į–Ĺ–Ķ –Ĺ–į –Ņ–ĺ–≤—ä—Ä—Ö–Ĺ–ĺ—Ā—ā—ā–į –Ĺ–į –Ņ–Ľ–į—Ā—ā–ł–Ĺ–į—ā–į –Ņ—Ä–Ķ–ī–ł –Ĺ–į–Ĺ–į—Ā—Ź–Ĺ–Ķ
- –Ņ–ĺ–ļ—Ä–ł–≤–į–Ĺ–Ķ –Ĺ–į —ą–į–Ī–Ľ–ĺ–Ĺ–ł—ā–Ķ —Ā –į–Ĺ—ā–ł–į–ī—Ö–Ķ–∑–ł–≤–Ķ–Ĺ —Ā–Ľ–ĺ–Ļ
- —Ą–ł–Ľ—ā—Ä–ł—Ä–į–Ĺ–Ķ –Ĺ–į —Ä–Ķ–∑–ł—Ā—ā–į
- –ł–∑—Ā—É—ą–į–≤–į–Ĺ–Ķ –Ņ—Ä–ł –ľ–Ĺ–ĺ–≥–ĺ –≤–ł—Ā–ĺ–ļ–į —ā–Ķ–ľ–Ņ–Ķ—Ä–į—ā—É—Ä–į
–•–į—Ä–į–ļ—ā–Ķ—Ä–ł—Ā—ā–ł–ļ–į, –Ņ—Ä—Ź–ļ–ĺ —Ā–≤—ä—Ä–∑–į–Ĺ–į —Ā —Ä–į–∑–ī–Ķ–Ľ–ł—ā–Ķ–Ľ–Ĺ–į—ā–į —Ā–Ņ–ĺ—Ā–ĺ–Ī–Ĺ–ĺ—Ā—ā, –Ķ –ļ–ĺ–Ĺ—ā—Ä–į—Ā—ā—ä—ā. –Ę–ĺ–Ļ –Ķ –ľ—Ź—Ä–ļ–į –∑–į —Ä–į–∑–ī–Ķ–Ľ–ł—ā–Ķ–Ľ–Ĺ–į—ā–į —Ā–Ņ–ĺ—Ā–ĺ–Ī–Ĺ–ĺ—Ā—ā –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į. –í–ł—Ā–ĺ–ļ–ł—Ź—ā –ļ–ĺ–Ĺ—ā—Ä–į—Ā—ā –Ķ –Ĺ—É–∂–Ķ–Ĺ, –∑–į –ī–į –Ĺ–Ķ –ľ–ĺ–∂–Ķ —Ā–≤–Ķ—ā–Ľ–ł–Ĺ–į—ā–į, –ĺ—ā—Ä–į–∑–Ķ–Ĺ–į –ĺ—ā –Ņ–ĺ–ī–Ľ–ĺ–∂–ļ–į—ā–į –ł–Ľ–ł –Ņ–ĺ—Ź–≤–ł–Ľ–į —Ā–Ķ –Ņ–ĺ—Ä–į–ī–ł –ī–ł—Ą—Ä–į–ļ—Ü–ł–ĺ–Ĺ–Ĺ–ł—ā–Ķ –Ķ—Ą–Ķ–ļ—ā–ł, –ī–į –Ņ–ĺ–≤–Ľ–ł—Ź–Ķ –Ĺ–į —Ą–ĺ—Ä–ľ–ł—Ä–į–Ĺ–Ķ—ā–ĺ –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–Ĺ–į—ā–į –ľ–į—Ā–ļ–į. –ö–ĺ–Ĺ—ā—Ä–į—Ā—ā—ä—ā –Ķ —Ö–į—Ä–į–ļ—ā–Ķ—Ä–ł—Ā—ā–ł–ļ–į –Ĺ–į —Ā—ā—Ä—ä–ľ–Ĺ–ĺ—Ā—ā—ā–į –Ĺ–į —Ä–Ķ–Ľ–Ķ—Ą–į –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į —Ā–Ľ–Ķ–ī –Ņ—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ—ā–ĺ. –ö–ĺ–Ĺ—ā—Ä–į—Ā—ā—ä—ā —Ā–Ķ –ĺ–Ņ—Ä–Ķ–ī–Ķ–Ľ—Ź —á—Ä–Ķ–∑ —Ö–į—Ä–į–ļ—ā–Ķ—Ä–ł—Ā—ā–ł—á–Ĺ–ł –ļ—Ä–ł–≤–ł:

–ó–į –ī–į —Ā–Ķ –Ņ–ĺ–≤–ł—ą–ł –ļ–ĺ–Ĺ—ā—Ä–į—Ā—ā—ä—ā, —Ā–Ľ–Ķ–ī –Ķ–ļ—Ā–Ņ–ĺ–Ĺ–ł—Ä–į–Ĺ–Ķ—ā–ĺ –ī–ĺ –Ņ—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ—ā–ĺ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā—ä—ā —Ā–Ķ —Ā—É—ą–ł, –∑–į –ī–į –ľ–ĺ–∂–Ķ –ī–į –ī–ĺ—Ā—ā–ł–≥–Ĺ–Ķ¬†–Ķ–ī–Ĺ–ĺ—Ä–ĺ–ī–Ĺ–į –Ņ–Ľ—ä—ā–Ĺ–ĺ—Ā—ā. –ě—Ā–≤–Ķ–Ĺ —ā–ĺ–≤–į, –≤—ä–∑–ľ–ĺ–∂–Ĺ–ĺ –Ķ –ī–į —Ā–Ķ –ł–∑–Ņ–ĺ–Ľ–∑–≤–į—ā –į–Ĺ—ā–ł–ĺ—ā—Ä–į–∑—Ź–≤–į—Č–ł –Ņ–ĺ–ļ—Ä–ł—ā–ł—Ź –≤—ä—Ä—Ö—É —Ā–ł–Ľ–ł—Ü–ł–Ķ–≤–į—ā–į –Ņ–ĺ–ī–Ľ–ĺ–∂–ļ–į –∑–į –Ņ—Ä–Ķ–ľ–į—Ö–≤–į–Ĺ–Ķ –Ĺ–į –≤—ä—ā—Ä–Ķ—ą–Ĺ–ĺ—ā–ĺ –ĺ—ā—Ä–į–∂–Ķ–Ĺ–ł–Ķ –≤—ä–≤ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–Ĺ–ł—Ź —Ą–ł–Ľ–ľ. –Ę–ĺ–≤–į —Ź–≤–Ľ–Ķ–Ĺ–ł–Ķ –≤—ä–∑–Ĺ–ł–ļ–≤–į, —ā—ä–Ļ –ļ–į—ā–ĺ –ĺ—ā—Ä–į–∑–Ķ–Ĺ–ł—Ź—ā –Ņ–ĺ—ā–ĺ–ļ –ł–Ĺ—ā–Ķ—Ä—Ą–Ķ—Ä–ł—Ä–į —Ā –Ņ—Ä–ĺ—Ö–ĺ–ī—Ź—Č–į—ā–į —Ā–≤–Ķ—ā–Ľ–ł–Ĺ–į, –Ņ—Ä–Ķ–ī–ł–∑–≤–ł–ļ–≤–į–Ļ–ļ–ł –ī–ĺ–Ņ—ä–Ľ–Ĺ–ł—ā–Ķ–Ľ–Ĺ–ĺ –ĺ—Ā–≤–Ķ—ā—Ź–≤–į–Ĺ–Ķ –≤ –ľ–Ķ—Ā—ā–į, –∑–į—Č–ł—ā–Ķ–Ĺ–ł —Ā –Ĺ–Ķ–Ņ—Ä–ĺ–∑—Ä–į—á–Ĺ–ł —É—á–į—Ā—ā—ä—Ü–ł –Ĺ–į —Ą–ĺ—ā–ĺ—ą–į–Ī–Ľ–ĺ–Ĺ–į. –í —Ä–Ķ–∑—É–Ľ—ā–į—ā —Ā–Ķ –ĺ–Ī—Ä–į–∑—É–≤–į —ā.–Ĺ. "–ĺ—Ä–Ķ–ĺ–Ľ", –Ņ—Ä–Ķ–ī–ł–∑–≤–ł–ļ–≤–į—Č –Ĺ–Ķ–ĺ—ā—á–Ķ—ā–Ľ–ł–≤–ĺ –ł–∑–ĺ–Ī—Ä–į–∂–Ķ–Ĺ–ł–Ķ —Ā —Ä–į–∑–ľ–ł—ā–ł –ļ—Ä–į–ł—Č–į.
–ė–∑–Ņ–ĺ–Ľ–∑–≤–į–Ĺ–Ķ—ā–ĺ –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł –≤ –Ĺ—Ź–ļ–ĺ–ł —ā–Ķ—Ö–Ĺ–ĺ–Ľ–ĺ–≥–ł—á–Ĺ–ł –Ņ—Ä–ĺ—Ü–Ķ—Ā–ł –Ņ–ĺ—Ā—ā–į–≤—Ź –ī–ĺ–Ņ—ä–Ľ–Ĺ–ł—ā–Ķ–Ľ–Ĺ–ł –ł–∑–ł—Ā–ļ–≤–į–Ĺ–ł—Ź ‚Äď –ł–∑–Ī–ĺ—Ä—ä—ā –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į —ā—Ä—Ź–Ī–≤–į –ī–į –Ķ —Ā–Ņ–ĺ—Ä–Ķ–ī —ā–ĺ—á–Ĺ–į—ā–į —ā–Ķ—Ö–Ĺ–ĺ–Ľ–ĺ–≥–ł—Ź, —Ā –ļ–ĺ—Ź—ā–ĺ —Č–Ķ –Ī—ä–ī–Ķ —É–Ņ–ĺ—ā—Ä–Ķ–Ī–Ķ–Ĺ. –ó–į —ā–ĺ–≤–į –Ķ –Ĺ–Ķ–ĺ–Ī—Ö–ĺ–ī–ł–ľ–ĺ –ī–į —Ā–Ķ –ĺ—ā—á–Ķ—ā–į—ā —ā.–Ĺ. –ļ—Ä–ł—ā–ł—á–Ĺ–ł —Ö–į—Ä–į–ļ—ā–Ķ—Ä–ł—Ā—ā–ł–ļ–ł –Ĺ–į –ľ–į—ā–Ķ—Ä–ł–į–Ľ–į (—Ą–ł–∑–ł–ļ–ĺ-—Ö–ł–ľ–ł—á–Ĺ–ł), –∑–Ĺ–į–Ĺ–ł–Ķ—ā–ĺ –Ĺ–į –ļ–ĺ–ł—ā–ĺ —Č–Ķ –Ņ–ĺ–∑–≤–ĺ–Ľ–ł —Ā –≥–ĺ–Ľ—Ź–ľ–į —Ā—ā–Ķ–Ņ–Ķ–Ĺ –Ĺ–į –≤–Ķ—Ä–ĺ—Ź—ā–Ĺ–ĺ—Ā—ā –ī–į —Ā–Ķ –ĺ–Ņ—Ä–Ķ–ī–Ķ–Ľ–ł –≤—ä–∑–ľ–ĺ–∂–Ĺ–ĺ—Ā—ā—ā–į –ł –Ķ—Ą–Ķ–ļ—ā–ł–≤–Ĺ–ĺ—Ā—ā—ā–į –Ĺ–į –ł–∑–Ņ–ĺ–Ľ–∑–≤–į–Ĺ–Ķ—ā–ĺ –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā –≤ —Ä–į–∑—Ä–į–Ī–ĺ—ā–≤–į–Ĺ–į—ā–į —ā–Ķ—Ö–Ĺ–ĺ–Ľ–ĺ–≥–ł—Ź. –Ě–Ķ–ĺ–Ī—Ö–ĺ–ī–ł–ľ–į –Ķ –Ņ–ĺ–ī—Ä–ĺ–Ī–Ĺ–į –Ņ—Ä–Ķ–ī—Ā—ā–į–≤–į –∑–į –≤—Ā–Ķ–ļ–ł —Ā—ā–į–ī–ł–Ļ –Ĺ–į —Ą–ł–∑–ł–ļ–ĺ-—Ö–ł–ľ–ł—á–Ķ—Ā–ļ–ł—ā–Ķ –Ņ—Ä–ĺ—Ü–Ķ—Ā–ł, –Ņ—Ä–ĺ—ā–ł—á–į—Č–ł –Ņ—Ä–ł –ł–∑–Ņ—ä–Ľ–Ĺ—Ź–≤–į–Ĺ–Ķ –Ĺ–į —Ą–ĺ—ā–ĺ–Ľ–ł—ā–ĺ–≥—Ä–į—Ą–ł—Ź.
–ü–ĺ–∑–ł—ā–ł–≤–Ĺ–ł —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł
–Ę–Ķ —Ā–į "—Ä–į–Ī–ĺ—ā–Ĺ–ĺ—ā–ĺ –ī–ĺ–Ī–ł—á–Ķ" –Ĺ–į –ľ–ł–ļ—Ä–ĺ–Ķ–Ľ–Ķ–ļ—ā—Ä–ĺ–Ĺ–Ĺ–į—ā–į –Ņ—Ä–ĺ–ľ–ł—ą–Ľ–Ķ–Ĺ–ĺ—Ā—ā. –ē–ļ—Ā–Ņ–ĺ–Ĺ–ł—Ä–į–Ĺ–ł—ā–Ķ –ĺ–Ī–Ľ–į—Ā—ā–ł —Ā–į —Ä–į–∑—ā–≤–ĺ—Ä–ł–ľ–ł –ł —Ā–Ľ–Ķ–ī –Ņ—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ—ā–ĺ —Ā–Ķ —Ä–į–∑—Ä—É—ą–į–≤–į—ā. ¬†–ú–ĺ–≥–į—ā –ī–į —Ā–Ķ –ł–∑–Ņ–ĺ–Ľ–∑–≤–į—ā –∑–į –Ķ–ļ—Ā–Ņ–ĺ–Ĺ–ł—Ä–į–Ĺ–Ķ —Ā —É–Ľ—ā—Ä–į–≤–ł–ĺ–Ľ–Ķ—ā–ĺ–≤–į —Ā–≤–Ķ—ā–Ľ–ł–Ĺ–į —Ā —Ä–į–∑–Ľ–ł—á–Ĺ–ł –ī—ä–Ľ–∂–ł–Ĺ–ł –Ĺ–į –≤—ä–Ľ–Ĺ–ł—ā–Ķ, –Ĺ–į–Ņ—Ä. —Ā I- (365 –Ĺ–ľ) –ł G- (436 –Ĺ–ľ) –Ľ–ł–Ĺ–ł—Ź, –į —Ā—ä—Č–ĺ —ā–į–ļ–į —Ā—ä—Ā —Ā–≤–Ķ—ā–Ľ–ł–Ĺ–į —Ā –ī—ä–Ľ–∂–ł–Ĺ–į –Ĺ–į –≤—ä–Ľ–Ĺ–į—ā–į 248 –Ĺ–ľ. –Ě–Ķ–∑–į–≤–ł—Ā–ł–ľ–ĺ –ĺ—ā —Ą–į–ļ—ā–į, —á–Ķ –∑–į –ī–į —Ā–Ķ –Ņ–ĺ–≤–ł—ą–ł –Ķ—Ą–Ķ–ļ—ā–ł–≤–Ĺ–ĺ—Ā—ā—ā–į, –Ņ—Ä–ł –Ņ–ĺ—Ā–Ľ–Ķ–ī–Ĺ–ł—Ź –Ņ—Ä–ĺ—Ü–Ķ—Ā —á–Ķ—Ā—ā–ĺ —Ā–Ķ –ł–∑–Ņ–ĺ–Ľ–∑–≤–į —Ö–ł–ľ–ł—á–Ķ—Ā–ļ–ł —É—Ā–ł–Ľ–Ķ–Ĺ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā, –ĺ–Ī–ł–ļ–Ĺ–ĺ–≤–Ķ–Ĺ–ł—ā–Ķ –Ņ–ĺ–∑–ł—ā–ł–≤–Ĺ–ł —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł –Ņ—Ä–ĺ–ī—ä–Ľ–∂–į–≤–į—ā –ī–į –Ī—ä–ī–į—ā –≤ —É–Ņ–ĺ—ā—Ä–Ķ–Ī–į. –ě—Ā–≤–Ķ–Ĺ —ā–ĺ–≤–į, —ā–Ķ —Ā–Ķ –ł–∑–Ņ–ĺ–Ľ–∑–≤–į—ā –ł –∑–į –Ņ—Ä–ĺ–ł–∑–≤–ĺ–ī—Ā—ā–≤–ĺ –Ĺ–į –ľ–į–≥–Ĺ–ł—ā–Ĺ–ł –≥–Ľ–į–≤–ł —Ā –ľ–į–Ľ–ļ–ł —Ä–į–∑–ľ–Ķ—Ä–ł, –ľ–ł–ļ—Ä–ĺ–Ņ—Ä–Ķ–≤–ļ–Ľ—é—á–≤–į—ā–Ķ–Ľ–ł, –Ņ–Ľ–į–Ĺ–į—Ä–Ĺ–ł –ľ–ł–ļ—Ä–ĺ–ľ–ĺ—ā–ĺ—Ä–ł, –ľ–ł–ļ—Ä–ĺ–ł–Ĺ–ī—É–ļ—ā–ł–≤–Ĺ–ł –Ķ–Ľ–Ķ–ľ–Ķ–Ĺ—ā–ł, –Ņ–Ľ–į–Ĺ–į—Ä–Ĺ–ł –°–í–ß —É—Ā—ā—Ä–ĺ–Ļ—Ā—ā–≤–į –ł –ī—Ä. –ü–ĺ–Ľ–ł–ľ–Ķ—Ä–Ĺ–į—ā–į –ĺ—Ā–Ĺ–ĺ–≤–į –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į ‚Äď —ā–Ķ—Ä–ľ–ĺ–Ņ–Ľ–į—Ā—ā–ł—á–Ĺ–ł—ā–Ķ —Ą–Ķ–Ĺ–ĺ–Ľ—Ą–ĺ—Ä–ľ–į–Ľ–ī–Ķ—Ö–ł–ī–Ĺ–ł —Ā–ľ–ĺ–Ľ–ł ‚Äď –ľ—É –Ņ—Ä–ł–ī–į–≤–į—ā –≤–į–∂–Ĺ–ł —Ā–≤–ĺ–Ļ—Ā—ā–≤–į –ļ–į—ā–ĺ –Ľ–Ķ—Ā–Ĺ–ĺ –ĺ–Ī—Ä–į–∑—É–≤–į–Ĺ–Ķ –Ĺ–į —Ą–ł–Ľ–ľ, –ĺ—ā–Ľ–ł—á–Ĺ–į –į–ī—Ö–Ķ–∑–ł—Ź, –ī–ĺ–Ī—Ä–į —É—Ā—ā–ĺ–Ļ—á–ł–≤–ĺ—Ā—ā...
–ě—Ā–ĺ–Ī–Ķ–Ĺ–ĺ—Ā—ā–ł –Ĺ–į –Ņ—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ—ā–ĺ
–•–į—Ä–į–ļ—ā–Ķ—Ä—ä—ā –ł —É—Ā–Ľ–ĺ–≤–ł—Ź—ā–į –Ĺ–į –Ņ—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ—ā–ĺ –∑–į–≤–ł—Ā—Ź—ā –ĺ—ā –≤–ł–ī–į –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–į –ł —É—Ā–Ľ–ĺ–≤–ł—Ź—ā–į –Ĺ–į –Ņ—Ä–Ķ–ī–≤–į—Ä–ł—ā–Ķ–Ľ–Ĺ–ĺ —Ā—É—ą–Ķ–Ĺ–Ķ –ł –Ķ–ļ—Ā–Ņ–ĺ–Ĺ–ł—Ä–į–Ĺ–Ķ. –ü—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ—ā–ĺ –Ķ —Ā–≤—ä—Ä–∑–į–Ĺ–ĺ —Ā –ł–∑—ā—Ä–ł–≤–į–Ĺ–Ķ –Ĺ–į –ĺ–Ī–Ľ—ä—á–Ķ–Ĺ–ł—ā–Ķ —É—á–į—Ā—ā—ä—Ü–ł —Ā –ĺ–Ī—Ä–į–Ī–ĺ—ā–ļ–į –≤ —Ā–ł–Ľ–Ĺ–ĺ —Ä–į–∑—Ä–Ķ–ī–Ķ–Ĺ–ł —Ä–į–∑—ā–≤–ĺ—Ä–ł –ĺ—ā –ļ–į–Ľ–ł–Ķ–≤ –ł –Ĺ–į—ā—Ä–ł–Ķ–≤ —Ö–ł–ī—Ä–ĺ–ļ—Ā–ł–ī KOH –ł NaOH (0,1-10% –≤ H2O) –ł–Ľ–ł –≤ 1-2 % —Ä–į–∑—ā–≤–ĺ—Ä –Ĺ–į —ā—Ä–ł–Ĺ–į—ā—Ä–ł–Ķ–≤ —Ą–ĺ—Ā—Ą–į—ā Na3PO4. –ü—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ—ā–ĺ –Ĺ–į –Ĺ–Ķ–≥–į—ā–ł–≤–Ĺ–ł—ā–Ķ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł –Ņ—Ä–Ķ–ī—Ā—ā–į–≤–Ľ—Ź–≤–į —Ä–į–∑—ā–≤–į—Ä—Ź–Ĺ–Ķ –Ĺ–į –Ĺ–Ķ–ĺ–Ī–Ľ—ä—á–Ķ–Ĺ–ł—ā–Ķ —É—á–į—Ā—ā—ä—Ü–ł –≤ –ĺ—Ä–≥–į–Ĺ–ł—á–Ĺ–ł —Ä–į–∑—ā–≤–ĺ—Ä–ł—ā–Ķ–Ľ–ł (—ā–ĺ–Ľ—É–ĺ–Ľ, –ī–ł–ĺ–ļ—Ā–į–Ĺ, —Ö–Ľ–ĺ—Ä–Ī–Ķ–Ĺ–∑–ĺ–Ľ, —ā—Ä–ł—Ö–Ľ–ĺ—Ä–Ķ—ā–ł–Ľ–Ķ–Ĺ –ł –ī—Ä.). –ü—Ä–ł –Ņ–ĺ–∑–ł—ā–ł–≤–Ĺ–ł—ā–Ķ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł, –∑–į —Ä–į–∑–Ľ–ł–ļ–į –ĺ—ā –Ĺ–Ķ–≥–į—ā–ł–≤–Ĺ–ł—ā–Ķ, –Ĺ–Ķ —Ā–Ķ –Ĺ–į–Ī–Ľ—é–ī–į–≤–į –Ņ–ĺ–ī—É–≤–į–Ĺ–Ķ –Ĺ–į –Ĺ–Ķ–ĺ–Ī–Ľ—ä—á–Ķ–Ĺ–ł—ā–Ķ —É—á–į—Ā—ā—ä—Ü–ł. –ü–ĺ—Ä–į–ī–ł —ā–ĺ–≤–į —ā–Ķ –ł–ľ–į—ā –Ņ–ĺ-–≤–ł—Ā–ĺ–ļ–į —Ä–į–∑–ī–Ķ–Ľ–ł—ā–Ķ–Ľ–Ĺ–į —Ā–Ņ–ĺ—Ā–ĺ–Ī–Ĺ–ĺ—Ā—ā –ł —ā—Ź –≤ –Ņ–ĺ-–ľ–į–Ľ–ļ–į —Ā—ā–Ķ–Ņ–Ķ–Ĺ —Ā–Ķ –≤–Ľ–ł—Ź–Ķ –ĺ—ā –ī–Ķ–Ī–Ķ–Ľ–ł–Ĺ–į—ā–į –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–Ĺ–ł—Ź —Ą–ł–Ľ–ľ.

–Ě–Ķ–≥–į—ā–ł–≤–Ĺ–ł —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł
–ú–Ķ—ā–ĺ–ī –∑–į –Ņ–ĺ–Ľ—É—á–į–≤–į–Ĺ–Ķ –Ĺ–į –ł–∑–ĺ–Ī—Ä–į–∂–Ķ–Ĺ–ł–Ķ –Ņ—Ä–ł –Ĺ–Ķ–≥–į—ā–ł–≤–Ĺ–ł—ā–Ķ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł –Ĺ–į –Ņ–ĺ–Ľ–ł–ľ–Ķ—Ä–Ĺ–į –ĺ—Ā–Ĺ–ĺ–≤–į –Ķ —Ą–ĺ—ā–ĺ–Ņ–ĺ–Ľ–ł–ľ–Ķ—Ä–ł–∑–į—Ü–ł—Ź—ā–į. –ē–ļ—Ā–Ņ–ĺ–Ĺ–ł—Ä–į–Ĺ–ł—ā–Ķ –ĺ–Ī–Ľ–į—Ā—ā–ł —Ā—ā–į–≤–į—ā –Ĺ–Ķ—Ä–į–∑—ā–≤–ĺ—Ä–ł–ľ–ł –ł —ā–į–ļ–į —Ā–Ľ–Ķ–ī –Ņ—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ —Ā–Ķ –Ņ—Ä–Ķ–ľ–į—Ö–≤–į—ā —Ā–į–ľ–ĺ –Ĺ–Ķ–Ķ–ļ—Ā–Ņ–ĺ–Ĺ–ł—Ä–į–Ĺ–ł—ā–Ķ. –ü—Ä–∑ 1972 –≥. –Ķ –ī–ĺ—Ā—ā–ł–≥–Ĺ–į—ā –Ņ—Ä–Ķ–ī–Ķ–Ľ—ä—ā –Ĺ–į –Ĺ–į –ī–Ķ—ā–į–Ļ–Ľ–Ĺ–ĺ—Ā—ā –Ņ—Ä–ł –ł–∑–Ņ–ĺ–Ľ–∑–≤–į–Ĺ–Ķ –Ĺ–į –Ĺ–Ķ–≥–į—ā–ł–≤–Ĺ–ł —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł –ł –∑–į —ā–Ķ—Ö–Ĺ–ĺ–Ľ–ĺ–≥–ł—á–Ķ–Ĺ –Ņ—Ä–ĺ—Ü–Ķ—Ā –Ņ–ĺ–ī 2 –ľ–ļ–ľ –∑–į–Ņ–ĺ—á–≤–į—ā –ī–į —Ā–Ķ –ł–∑–Ņ–ĺ–Ľ–∑–≤–į—ā –Ņ–ĺ–∑–ł—ā–ł–≤–Ĺ–ł—ā–Ķ.
–í —Ā—Ä–į–≤–Ĺ–Ķ–Ĺ–ł–Ķ —Ā –Ņ–ĺ–∑–ł—ā–ł–≤–Ĺ–ł—ā–Ķ –Ĺ–Ķ–≥–į—ā–ł–≤–Ĺ–ł—ā–Ķ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł –ł–ľ–į—ā –ľ–Ĺ–ĺ–≥–ĺ –Ņ—Ä–Ķ–ł–ľ—É—Č–Ķ—Ā—ā–≤–į:
- —ą–ł—Ä–ĺ–ļ –ł–∑–Ī–ĺ—Ä –ĺ—ā —ā–Ķ—Ö–Ĺ–ĺ–Ľ–ĺ–≥–ł—á–Ĺ–ł –Ņ–į—Ä–į–ľ–Ķ—ā—Ä–ł (–≤—ä–∑–ľ–ĺ–∂–Ĺ–ł –∑–į –ł–∑–Ņ–ĺ–Ľ–∑–≤–į–Ĺ–Ķ —ā–Ķ—Ö–Ĺ–ĺ–Ľ–ĺ–≥–ł–ł), –ļ–ĺ–Ķ—ā–ĺ –Ņ–ĺ–∑–≤–ĺ–Ľ—Ź–≤–į –Ņ–ĺ–≤–Ķ—á–Ķ –≤—ä–∑–ľ–ĺ–∂–Ĺ–ĺ—Ā—ā–ł –∑–į –Ņ–ĺ–Ľ—É—á–į–Ĺ–Ķ –Ĺ–į –≤–ł—Ā–ĺ–ļ–ĺ–ļ–į—á–Ķ—Ā—ā–≤–Ķ–Ĺ–ł —Ä–Ķ–∑–ł—Ā—ā–Ĺ–ł –ľ–į—Ā–ļ–ł
- –Ĺ–Ķ—á—É–≤—Ā—ā–≤–ł—ā–Ķ–Ľ–Ĺ–ĺ—Ā—ā –ļ—ä–ľ –Ņ—Ä–Ķ-–Ņ—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ
- –ī–ĺ–Ī—Ä–į –į–ī—Ö–Ķ–∑–ł—Ź –ł —É—Ā—ā–ĺ–Ļ—á–ł–≤–ĺ—Ā—ā –ļ—ä–ľ –ľ–ĺ–ļ—Ä–ĺ –Ķ—Ü–≤–į–Ĺ–Ķ
- –≤—ä–∑–ľ–ĺ–∂–Ĺ–ĺ—Ā—ā –∑–į "—Ā–į–ľ–ĺ–ļ–ĺ—Ä–Ķ–ļ—Ü–ł—Ź", —ā–ĺ–Ķ—Ā—ā —Ä–į–∑–ľ–Ķ—Ä–ł—ā–Ķ –Ĺ–į –Ĺ–Ķ–Ķ–ļ—Ā–Ņ–ĺ–Ĺ–ł—Ä–į–Ĺ–ł—ā–Ķ —É—á–į—Ā—ā—ä—Ü–ł –ľ–ĺ–≥–į—ā –ī–į —Ā–Ķ –ļ–ĺ—Ä–ł–≥–ł—Ä–į—ā –≤ –∂–Ķ–Ľ–į–Ĺ–į—ā–į –Ņ–ĺ—Ā–ĺ–ļ–į —á—Ä–Ķ–∑ –Ņ–ĺ–ī–Ķ—Ü–≤–į–Ĺ–Ķ –Ņ—Ä–ł –≤—ā–ĺ—Ä–ł—á–Ĺ–ĺ –ł–∑–ĺ—ā—Ä–ĺ–Ņ–Ĺ–ĺ –Ķ—Ü–≤–į–Ĺ–Ķ
- —ą–ł—Ä–ĺ–ļ –ł–∑–Ī–ĺ—Ä –Ĺ–į –Ņ—Ä–ĺ—Ź–≤–ł—ā–Ķ–Ľ–Ĺ–ł —Ā—ä—Ā—ā–į–≤–ł –ł —Ö–ł–ľ–ł–ļ–į–Ľ–ł
–Ě–į–Ļ-–≥–ĺ–Ľ–Ķ–ľ–ł—ā–Ķ –Ĺ–Ķ–ī–ĺ—Ā—ā–į—ā—ä—Ü–ł –Ĺ–į –Ĺ–Ķ–≥–į—ā–ł–≤–Ĺ–ł—ā–Ķ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł —Ā–į —Ā–Ľ–Ķ–ī–Ĺ–ł—ā–Ķ:
- —Ä–į–∑–ī–Ķ–Ľ–ł—ā–Ķ–Ľ–Ĺ–į—ā–į —Ā–Ņ–ĺ—Ā–ĺ–Ī–Ĺ–ĺ—Ā—ā –Ķ –ĺ–≥—Ä–į–Ĺ–ł—á–Ķ–Ĺ–į –ĺ—ā –ī–Ķ–Ī–Ķ–Ľ–ł–Ĺ–į—ā–į –Ĺ–į —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–Ĺ–ł—Ź —Ą–ł–Ľ–ľ. –°—ä—Č–Ķ—Ā—ā–≤—É–≤–į –Ķ–ľ–Ņ–ł—Ä–ł—á–Ĺ–ĺ –Ņ—Ä–į–≤–ł–Ľ–Ĺ–ĺ, —Ā—ä–≥–Ľ–į—Ā–Ĺ–ĺ –ļ–ĺ–Ķ—ā–ĺ —ā–ł–Ņ–ł—á–Ĺ–ł—ā–Ķ –ļ—Ä–ł—ā–ł—á–Ĺ–ł —Ä–į–∑–ľ–Ķ—Ä–ł –Ĺ–į –Ņ–ĺ–Ľ—É—á–į–≤–į–Ĺ–ł—ā–Ķ —á—Ä–Ķ–∑ —Ą–ĺ—ā–ĺ–Ľ–ł—ā–ĺ–≥—Ä–į—Ą—Ā–ļ–ł –ľ–Ķ—ā–ĺ–ī –Ķ–Ľ–Ķ–ľ–Ķ–Ĺ—ā–ł —Ā–į –Ĺ–Ķ –Ņ–ĺ-–ľ–į–Ľ–ļ–ł –ĺ—ā —É—ā—Ä–ĺ–Ķ–Ĺ–į—ā–į –ī–Ķ–Ī–Ķ–Ľ–ł–Ĺ–į –Ĺ–į —Ā–Ľ–ĺ—Ź
- –ļ–ł—Ā–Ľ–ĺ—Ä–ĺ–ī—ä—ā –ľ–Ĺ–ĺ–≥–ĺ –ł–Ĺ—Ö–ł–Ī–ł—Ä–į (–∑–į–Ī–į–≤—Ź) –Ņ—Ä–ĺ—Ü–Ķ—Ā–į –Ĺ–į –ĺ–Ī—Ä–į–∑—É–≤–į–Ĺ–Ķ –Ĺ–į —Ä–Ķ–∑–ł—Ā—ā–Ĺ–ł –ľ–į—Ā–ļ–ł –ĺ—ā —ā–ĺ–∑–ł —ā–ł–Ņ —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł
–í –ľ–ĺ–ľ–Ķ–Ĺ—ā–į –Ĺ–į–Ļ-—á–Ķ—Ā—ā–ĺ —Ā–Ķ –ł–∑–Ņ–ĺ–Ľ–∑–≤–į—ā —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł –ĺ—ā —Ā–Ķ—Ä–ł—Ź—ā–į MICROPOSIT S1800‚ĄĘ. –ü–ĺ–Ľ—É—á–Ķ–Ĺ–ł—Ź—ā –ĺ—ā —ā—Ź—Ö —Ą–ł–Ľ–ľ —Ā–Ķ —Ö–į—Ä–į–ļ—ā–Ķ—Ä–ł–∑–ł—Ä–į —Ā –ĺ—ā—Ā—ä—Ā—ā–≤–ł–Ķ –Ĺ–į –ľ–Ķ—Ö–į–Ĺ–ł—á–Ĺ–ĺ –Ĺ–į–Ņ—Ä–Ķ–∂–Ķ–Ĺ–ł–Ķ, –ĺ—ā–Ľ–ł—á–Ĺ–į –į–ī—Ö–Ķ–∑–ł—Ź, –≤–ł—Ā–ĺ–ļ–į –Ķ–ī–Ĺ–ĺ—Ä–ĺ–ī–Ĺ–ĺ—Ā—ā –Ĺ–į —Ā–Ľ–ĺ—Ź. –Ę–Ķ–∑–ł —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł —Ā–į –ĺ–Ņ—ā–ł–ľ–ł–∑–ł—Ä–į–Ĺ–ł –∑–į –Ķ–ļ—Ā–Ņ–ĺ–Ĺ–ł—Ä–į–Ĺ–Ķ —Ā g-–Ľ–ł–Ĺ–ł—Ź—ā–į –Ĺ–į –∂–ł–≤–į—á–Ĺ–į –Ľ–į–ľ–Ņ–į (436 –Ĺ–ľ). –ó–į –Ņ—Ä–ĺ—Ź–≤—Ź–≤–į–Ĺ–Ķ –Ĺ–į —Ä–Ķ–∑–ł—Ā—ā–Ĺ–į—ā–į –ľ–į—Ā–ļ–į —Ā–Ķ –Ņ—Ä–Ķ–Ņ–ĺ—Ä—ä—á–≤–į –ł–∑–Ņ–ĺ–Ľ–∑–≤–į–Ĺ–Ķ—ā–ĺ –Ĺ–į MICROPOSIT MF-319, –į —Ä–Ķ–∑–ł—Ā—ā–Ĺ–į—ā–į –ľ–į—Ā–ļ–į —Ā–Ķ –ł–∑—ā—Ä–ł–≤–į –Ī–Ķ–∑ –ĺ—Ā—ā–į—ā—ä—Ü–ł –Ņ—Ä–ł —É–Ņ–ĺ—ā—Ä–Ķ–Ī–į –Ĺ–į MICROPOSIT REMOVER.
–†–Ķ–≤–Ķ—Ä—Ā–ł–≤–Ĺ–ł
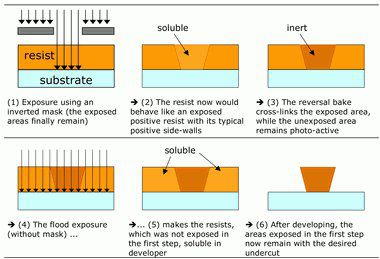
–°—ä—Č–Ķ—Ā—ā–≤—É–≤–į—ā –ł —ā.–Ĺ. —Ä–Ķ–≤–Ķ—Ä—Ā–ł–≤–Ĺ–ł —Ą–ĺ—ā–ĺ—Ä–Ķ–∑–ł—Ā—ā–ł (image reversal photoresist). –Ę–Ķ —Ā–į –ĺ—Ā–ĺ–Ī–Ķ–Ĺ –≤–ł–ī, –ļ–ĺ–Ļ—ā–ĺ —Ā–Ľ–Ķ–ī –Ķ–ļ—Ā–Ņ–ĺ–Ĺ–ł—Ä–į–Ĺ–Ķ —Ā–Ķ –ī—ä—Ä–∂–ł –ļ–į—ā–ĺ –Ņ–ĺ–∑–ł—ā–ł–≤–Ķ–Ĺ, –Ĺ–ĺ –ľ–ĺ–≥–į—ā –ī–į –Ī—ä–ī–į—ā "–Ņ—Ä–Ķ–≤—ä—Ä–Ĺ–į—ā–ł" –≤ –Ĺ–Ķ–≥–į—ā–ł–≤–Ĺ–ł —á—Ä–Ķ–∑ —ā–ĺ–Ņ–Ľ–ł–Ĺ–Ĺ–į –ĺ–Ī—Ä–į–Ī–ĺ—ā–ļ–į –ł –Ņ–ĺ—Ā–Ľ–Ķ–ī–≤–į—Č–ĺ –Ķ–ļ—Ā–Ņ–ĺ–Ĺ–ł—Ä–į–Ĺ–Ķ –Ĺ–į —Ü–Ķ–Ľ–ł—Ź —Ā–Ľ–ĺ–Ļ (–≤–Ķ—á–Ķ –Ī–Ķ–∑ —Ą–ĺ—ā–ĺ—ą–į–Ī–Ľ–ĺ–Ĺ–į) —Ā —É–Ľ—ā—Ä–į–≤–ł–ĺ–Ľ–Ķ—ā–ĺ–≤–į —Ā–≤–Ķ—ā–Ľ–ł–Ĺ–į. –í —ā–į–ļ—ä–≤ —Ā–Ľ—É—á–į–Ļ —Ä–Ķ–∑–ł—Ā—ā—ä—ā –≤–Ķ—á–Ķ —Ā–Ķ –ī—ä—Ä–∂–ł –ļ–į—ā–ĺ –Ĺ–Ķ–≥–į—ā–ł–≤–Ķ–Ĺ. –ě—Ā–Ĺ–ĺ–≤–Ĺ–į—ā–į —Ä–į–∑–Ľ–ł–ļ–į –Ĺ–į –ł–∑–ĺ–Ī—Ä–į–∂–Ķ–Ĺ–ł–Ķ—ā–ĺ, –Ņ–ĺ–Ľ—É—á–Ķ–Ĺ–ĺ –Ņ–ĺ —ā–į–ļ—ä–≤ –Ĺ–į—á–ł–Ĺ, –≤ —Ā—Ä–į–≤–Ĺ–Ķ–Ĺ–ł–Ķ —Ā –ĺ–Ī–ł–ļ–Ĺ–ĺ–≤–Ķ–Ĺ–ĺ—ā–ĺ –ł–∑–Ņ–ĺ–Ľ–∑–≤–į–Ĺ–Ķ –Ĺ–į –Ņ–ĺ–∑–ł—ā–ł–≤–Ķ–Ĺ —Ä–Ķ–∑–ł—Ā—ā, –Ķ –≤ –Ĺ–į–ļ–Ľ–ĺ–Ĺ–į –Ĺ–į —Ā—ā–Ķ–Ĺ–ł—ā–Ķ –Ĺ–į –ľ–į—ā–Ķ—Ä–ł–į–Ľ–į. –ü—Ä–ł –Ņ–ĺ–∑–ł—ā–ł–≤–Ķ–Ĺ —Ä–Ķ–∑–ł—Ā—ā —Ā—ā–Ķ–Ĺ–ł—ā–Ķ —Ā–į –Ĺ–į–ļ–Ľ–ĺ–Ĺ–Ķ–Ĺ–ł –Ĺ–į–≤—ä–Ĺ, –ļ–ĺ–Ķ—ā–ĺ –Ī–Ľ–į–≥–ĺ–Ņ—Ä–ł—Ź—ā—Ā—ā–≤–į –Ņ—Ä–ĺ—Ü–Ķ—Ā–į –Ĺ–į –Ķ—Ü–≤–į–Ĺ–Ķ, –į –Ņ—Ä–ł "–ĺ–Ī—Ä—ä—Č–į–Ĺ–Ķ" –Ĺ–į –ł–∑–ĺ–Ī—Ä–į–∂–Ķ–Ĺ–ł–Ķ—ā–ĺ —Ā—ā–Ķ–Ĺ–ł—ā–Ķ —Ā–Ķ –Ĺ–į–ļ–Ľ–į–Ĺ—Ź—ā –Ĺ–į–≤—ä—ā—Ä–Ķ, –ļ–ĺ–Ķ—ā–ĺ –Ķ –Ņ—Ä–Ķ–ł–ľ—É—Č–Ķ—Ā—ā–≤–ĺ –Ņ—Ä–ł —ā.–Ĺ. –ĺ–Ī—Ä–į—ā–Ĺ–į –Ľ–ł—ā–ĺ–≥—Ä–į—Ą–ł—Ź –ł–Ľ–ł —Ā–≤–Ľ–ł—á–į–Ĺ–Ķ.
–ź–Ĺ—ā–ĺ–Ĺ –ě—Ä—É—ą, Sandacite.bg ‚Äď http://www.sandacite.bg
–ė–∑—ā–ĺ—á–Ĺ–ł—Ü–ł:
High-resolution permanent photoresist laminate for microsystem applications - http://nanolithography.spiedigitallibrary.org/article.aspx?articleid=1098769
Image Reversal Photoresists - http://www.microchemicals.com/products/photoresists/image_reversallift_off.html
Photolithography - http://www.ysu.edu/physics/tnoder/S07-PHYS2536/Notes/Chapter4-Photolithography.pdf
–õ–ł—ā–ĺ–≥—Ä–į—Ą–ł–ł –≤ –ľ–ł–ļ—Ä–ĺ—ć–Ľ–Ķ–ļ—ā—Ä–ĺ–Ĺ–ł–ļ–Ķ - https://mipt.ru/upload/medialibrary/53a/Lab_lithography.pdf
–ě—Č–Ķ –Ņ–ĺ —ā–Ķ–ľ–į—ā–į

–Ę–Ķ—Ö–Ĺ–ĺ–Ľ–ĺ–≥–ł–ł
–ö–ĺ–Ľ–ļ–ĺ —Ā—ā—Ä—É–≤–į –ī–į —Ā–ł –Ņ–ĺ—Ā—ā—Ä–ĺ–ł–ľ –∑–į–≤–ĺ–ī –∑–į –ľ–ł–ļ—Ä–ĺ–Ņ—Ä–ĺ—Ü–Ķ—Ā–ĺ—Ä–ł? (–≤–ł–ī–Ķ–ĺ)

–Ę–Ķ—Ö–Ĺ–ĺ–Ľ–ĺ–≥–ł–ł
–Ę—Ä–ł —Ä–Ķ—ā—Ä–ĺ –Ľ–į–ľ–Ņ–ĺ–≤–ł —É—Ā–ł–Ľ–≤–į—ā–Ķ–Ľ—Ź

–Ę–Ķ—Ö–Ĺ–ĺ–Ľ–ĺ–≥–ł–ł
–ö—Ä–į—ā–ļ–į –ł—Ā—ā–ĺ—Ä–ł—Ź –Ĺ–į —É—Ā–ł–Ľ–≤–į—ā–Ķ–Ľ–ł—ā–Ķ
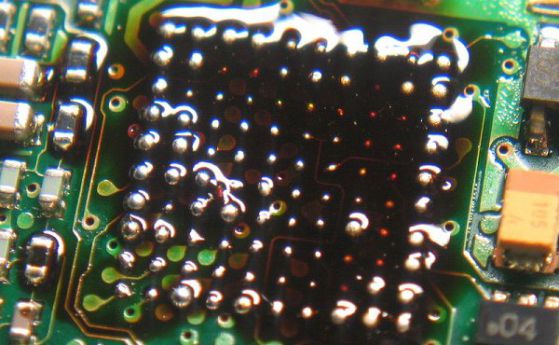




















–ö–ĺ–ľ–Ķ–Ĺ—ā–į—Ä–ł
–ú–ĺ–Ľ—Ź, —Ä–Ķ–≥–ł—Ā—ā—Ä–ł—Ä–į–Ļ—ā–Ķ —Ā–Ķ –ĺ—ā T–£–ö!
–ź–ļ–ĺ –≤–Ķ—á–Ķ –ł–ľ–į—ā–Ķ —Ä–Ķ–≥–ł—Ā—ā—Ä–į—Ü–ł—Ź, –Ĺ–į—ā–ł—Ā–Ĺ–Ķ—ā–Ķ –Ę–£–ö!
–Ě—Ź–ľ–į –ļ–ĺ–ľ–Ķ–Ĺ—ā–į—Ä–ł –ļ—ä–ľ —ā–į–∑–ł –Ĺ–ĺ–≤–ł–Ĺ–į !
–ü–ĺ—Ā–Ľ–Ķ–ī–Ĺ–ł –ļ–ĺ–ľ–Ķ–Ĺ—ā–į—Ä–ł
dolivo
–ó–Ķ–ľ–Ĺ–į—ā–į —Ź–Ī—ä–Ľ–ļ–į: —Ā—ā–į—Ä–į –ļ—É–Ľ—ā—É—Ä–į –∑–į –Ĺ–ĺ–≤–ł—ā–Ķ –ļ–Ľ–ł–ľ–į—ā–ł—á–Ĺ–ł –≤—Ä–Ķ–ľ–Ķ–Ĺ–į
dolivo
–ó–Ķ–ľ—Ź—ā–į –Ņ–ĺ—ā—ä–ľ–Ĺ—Ź–≤–į. –ö–į–ļ–≤–ĺ –ĺ–∑–Ĺ–į—á–į–≤–į —ā–į–∑–ł —ā—Ä–Ķ–≤–ĺ–∂–Ĺ–į –ļ–Ľ–ł–ľ–į—ā–ł—á–Ĺ–į —ā–Ķ–Ĺ–ī–Ķ–Ĺ—Ü–ł—Ź –∑–į –Ī—ä–ī–Ķ—Č–Ķ—ā–ĺ?
Nikor
–Ě–į 30 —Ā–Ķ–Ņ—ā–Ķ–ľ–≤—Ä–ł 1928 –Ķ –ĺ—ā–ļ—Ä–ł—ā –Ņ–Ķ–Ĺ–ł—Ü–ł–Ľ–ł–Ĺ—ä—ā
–ü—Ä–ĺ—Ā—ā –ß–ĺ–≤–Ķ–ļ
–Ě–ĺ–≤–ĺ –ĺ–Ī—Ź—Ā–Ĺ–Ķ–Ĺ–ł–Ķ –∑–į –≥–ł–≥–į–Ĺ—ā—Ā–ļ–ł—ā–Ķ –Ķ–ļ—Ā–Ņ–Ľ–ĺ–ī–ł—Ä–į—Č–ł –ļ—Ä–į—ā–Ķ—Ä–ł –≤ –°–ł–Ī–ł—Ä